光學發射光譜法於半導體製程監控與控制之應用
光學發射光譜法於半導體製程監控與控制之應用

摘要
光學發射光譜法在半導體產業中已經成為關鍵的分析技術,在半導體製造中的各種關鍵製程提供即時且原位的監控。
本文回顧了OES在半導體製造流程的原理與應用。探討OES的基本原理、儀器、資料分析技術與該領域的最新進展。此外,本文強調了OES在確保半導體製程的品質、可靠度與效率的重要性,為電子技術進步做出貢獻。
引言
1.1 半導體製程控制
隨著全球半導體產品的需求與日俱增,新的晶圓廠正在開發中以及現有的晶圓廠正被重新利用。為了趕上市場需求,確保產線在最高效率且將停機時間降至最低是當前的首要任務。OES提供一個成本效益高且可信賴的方式來確保這點。本文將會審視四種OES使用的方式,包含:
1.)電漿溫度監控
2.)蝕刻製程終點檢測
3.)沉積製程終點檢測
4.) 腔室清洗終點檢測
光學發射光譜法基礎
2.1 基本原理
物質的第四種型態是電離氣體,稱為電漿,它在被激發時會發射光子。這些光通常呈現為特定波長的窄頻發射譜線。這些發射譜線和強度可以透過為了這應用的光譜範圍和解析度而配置的光譜儀來監控。
2.2 發射譜線和光譜分析
1.)像圖一這樣的設置可以進行校正,將腔室功率與發射譜線峰值強度互相關聯。圖二是用六氟化硫(SF6)做例子。然後可以使用史蒂芬-玻爾茲曼輻照度方程式將其轉換為電漿溫度,如圖三所示。

( 圖一)

( 圖二)

( 圖三 )
2.)四氟化碳(CF4)電漿常用來蝕刻掉材料層,像是二氧化矽(SiO2)。使用時間分辨OES,可以透過監控電漿中的氧氣量,準確判定材料何時被完全移除。圖四展示了模擬透過在400~600nm區間的發射譜線強度監控氧氣濃度。在例子中,氧氣濃度會在製程認定完成時降至特定數值。

( 圖四 )
3.)氬氣電漿能電離金屬原子,透過電場可以加速射向晶圓,導致物理氣相沉積(PVD)製程,又稱為濺鍍。濺鍍的製程是高能粒子轟擊靶材,原子因此彈出。這些飛濺出的金屬原子然後沉積到基材上,形成薄膜。圖五是腔室的設置示意圖。氬氣電漿的濃度與溫度可以透過使用OES監控來確認金屬蒸發速率。然後,這可以進一步與沉積厚度隨時間的變化相關聯。
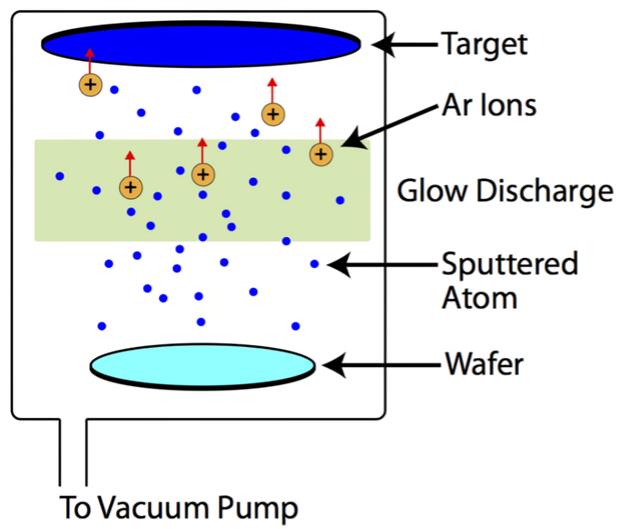
( 圖五 )
)電漿腔室內部可能會在蝕刻與沉積製程中,因殘留物質附著而形成塗層。這就需要對腔室進行清潔。使用氟基電漿(像是CF4 + O2)能有效清潔。透過監控O2與CF4的發射譜線強度比例可以檢測清潔程度。氧氣與氟的比例越高,表示反應室相對清潔,氧氣含量高於氟含量。這代表腔室正有效地移除氟殘留物。見圖六範例。

( 圖六 )
結論
光學發射光譜技術透過實現即時監測和控制,在半導體製程中繼續發揮至關重要的作用。儀器、資料分析技術與其他技術整合的進步,正在為提高半導體製造的製程效率、品質和良率奠定基礎。當產業往更小的尺寸與新的材料發展時,OES有望進一步發展,為半導體技術的持續進步做出貢獻。